Mastering ang sining ng paghihinang bola grid arrays
Ang posisyon ng mahusay at maaasahang semiconductor packaging ay hindi maaaring ma -overstated sa mabilis na umuusbong na mundo ng paggawa ng elektronikong aparato.Ang teknolohiya ng Ball Grid Array (BGA) ay lumilitaw bilang isang mainam na solusyon upang matugunan ang lumalagong mga hinihingi ng mga modernong electronics para sa mas mataas na pagganap at miniaturization.Ang artikulong ito ay naghuhukay sa masalimuot na mga detalye ng teknolohiya ng BGA, paggalugad ng mga panghuli na sangkap, proseso, at mga teknikal na hamon na tinutukoy nito sa semiconductor packaging.Mula sa pangunahing istraktura at pakinabang ng BGA sa mga tradisyunal na sistema na batay sa pin tulad ng quad flat pack hanggang sa sopistikadong mga proseso ng paghihinang, inspeksyon, at rework, ang diskurso ay nag-aalok ng isang komprehensibong pagsusuri.Catalog

Larawan 1: array ng grid ng bola
Mga Pangunahing Kaalaman ng Ball Grid Arrays
Ang isang ball grid array (BGA) ay isang modernong solusyon sa semiconductor packaging, na idinisenyo upang mapagtagumpayan ang mga hamon ng mas matanda, mga pamamaraan na batay sa pin tulad ng quad flat pack.Sa halip na gumamit ng mga marupok na pin, ang BGA ay umaasa sa isang hanay ng mga maliit na bola ng panghinang.Ang mga bola na ito ay tiyak na nakaposisyon sa ilalim ng pakete at sinadya upang kumonekta sa pagtutugma ng mga pad ng tanso sa isang nakalimbag na circuit board (PCB).Kapag pinainit, ang mga bola ng nagbebenta ay natutunaw at mai -secure ang BGA sa board, na lumilikha ng isang malakas at maaasahang koneksyon.
Ang format ng BGA ay nagbibigay ng maraming praktikal na pakinabang.Una, pinapasimple nito ang layout ng PCB sa pamamagitan ng pagbabawas ng pangangailangan para sa mga makapal na naka -pack na magkakaugnay na kinakailangan ng mas maaga na mga sistema ng packaging.Ang mas mahusay na layout na ito ay ginagawang mas matibay ang BGA at binabawasan ang panganib ng pinsala sa panahon ng paghawak, hindi katulad ng maselan na mga pin na matatagpuan sa mga mas lumang mga pakete na maaaring yumuko o madaling masira.
Bilang karagdagan, ang BGA ay nag -aalok ng mahusay na pamamahala ng init at pagganap ng kahusayan sa kuryente.Ang maikli, direktang koneksyon sa pagitan ng BGA at PCB ay tumutulong upang mawala ang init nang mas epektibo, na tumutulong na mapanatili ang katatagan ng mga circuit sa ilalim ng thermal stress.Gayundin, ang mas maiikling mga de -koryenteng landas sa loob ng BGA ay nagbabawas ng pagkawala ng signal, na lalo na malaki para sa mga aparato na nagpapatakbo sa mataas na frequency.Ang kumbinasyon ng tibay, pag -iwas ng init, at kahusayan sa kuryente ay ginagawang isang sikat na pagpili ng BGA para sa mga modernong elektronikong aparato habang lumalaki ang kanilang pagiging kumplikado at mga kahilingan sa pagganap.
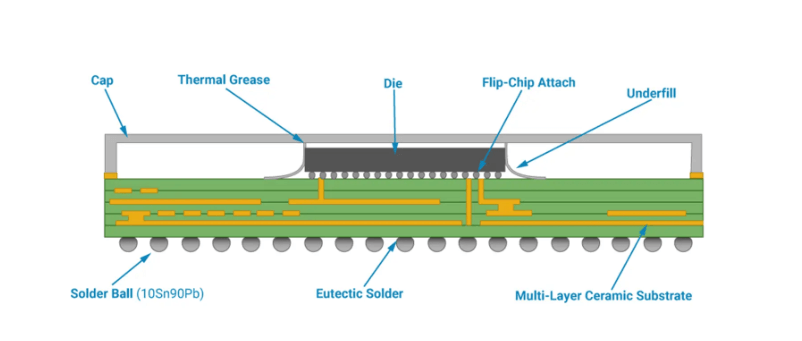
Larawan 2: proseso ng paghihinang ng BGA
Pag -navigate sa proseso ng BGA Solder
Ang proseso ng paghihinang ng isang bola grid array (BGA) ay una nang tinanong dahil sa mga alalahanin tungkol sa pagiging maaasahan nito at ang kahirapan sa pag -inspeksyon ng mga koneksyon na nakatago sa ilalim ng sangkap.Gayunpaman, sa paglipas ng panahon, ang paghihinang ng BGA ay napatunayan na mas maaasahan kaysa sa mga matatandang sistema, tulad ng quad flat pack, salamat sa tumpak na kontrol sa panahon ng proseso ng paghihinang.Ang pinahusay na pagiging maaasahan ay humantong sa malawakang paggamit nito sa parehong malakihang pagmamanupaktura at mas maliit, prototype na mga pagtitipon ng PCB.
Ang pamamaraan ng pagmumuni -muni ay nangingibabaw sa paglakip ng isang BGA sa isang nakalimbag na circuit board (PCB).Sa prosesong ito, ang buong pagpupulong ay pinainit sa isang tiyak na temperatura kung saan ang panghinang sa ilalim ng BGA ay natutunaw sa isang semi-likidong estado.Ang yugtong ito ay maingat na kinokontrol upang matiyak na ang panghinang ay nagpapanatili ng istraktura nito at hindi nagiging sanhi ng pagbagsak o pagsamahin ng mga bola ng bola.Ang tumpak na regulasyon ng temperatura ay seryoso dahil ang anumang pagbabagu -bago ay maaaring makaapekto sa kalidad ng mga koneksyon.
Ang isang malawak na tampok ng proseso ng pagmuni -muni ay ang paraan na kumikilos ang tinunaw na panghinang.Ang natural na pag-igting sa ibabaw nito ay tumutulong na hilahin ang BGA sa perpektong pagkakahanay sa mga PCB pad, kahit na ang sangkap ay bahagyang nasa labas ng sentro kapag inilagay.Ang kakayahang pagwawasto sa sarili ay nagsisiguro na ang bawat koneksyon ay maayos na ginawa nang walang manu-manong pagsasaayos.Ang mga advanced na pamamaraan na ito ay hindi lamang gumagawa ng BGA na paghihinang lubos na maaasahan ngunit mas mahusay din, na tumutulong upang gawin ang BGA na isang ginustong pagpipilian sa paggawa ng modernong circuit board.
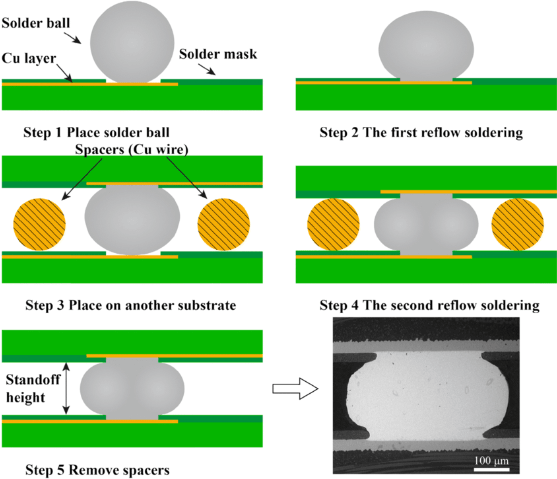
Larawan 3: BGA Solder Joint Inspection
Paano siyasatin nang epektibo ang mga kasukasuan ng BGA Solder?
Ang pag -inspeksyon ng mga kasukasuan ng BGA Solder ay isang iginiit na bahagi ng proseso ng pagpupulong, kumplikado sa pamamagitan ng ang katunayan na ang mga kasukasuan ay nakatago sa ilalim ng sangkap ng BGA.Dahil hindi ma-access ng tradisyonal na visual inspeksyon ang mga nakatagong koneksyon na ito, ang mga diskarte sa X-ray at awtomatikong X-ray Inspection (AXI) ay ginagamit upang makakuha ng isang malinaw, hindi nagsasalakay na pagtingin sa mga kasukasuan ng panghinang.
Ang inspeksyon ng X-ray ay kapaki-pakinabang para sa lubusan na suriin ang bawat pinagsamang panghinang.Pinapayagan ng imaging ang mga technician upang matiyak na ang lahat ng mga bola ng panghinang ay natunaw nang tama at nabuo ang mga malakas na bono sa PCB.Ang hakbang na ito ay ginagamit upang makilala ang mga problema tulad ng mga malamig na kasukasuan, kung saan ang panghinang ay hindi ganap na natunaw, o mga voids, na mga bulsa ng hangin na maaaring magpahina sa kasukasuan sa paglipas ng panahon.
Sa pamamagitan ng teknolohiya ng X-ray, maaaring kumpirmahin ng mga inspektor na ang tamang dami ng init ay inilapat sa panahon ng proseso ng pagmuni-muni at na ang mga nagbebenta ng mga kasukasuan ay nakakatugon sa tumpak na mga pamantayan.Ang antas ng pagsisiyasat na ito ay nagsisiguro na ang pangwakas na produkto ay maaasahan at makatiis sa mga stress sa pagpapatakbo na maaaring harapin nito, na tumutulong upang mapanatili ang mataas na kalidad ng pagmamanupaktura.
Ang mga mabisang diskarte para sa BGA Rework sa Electronics
Ang muling paggawa ng isang bahagi ng BGA ay isang lubos na tumpak na gawain na nangangailangan ng maingat na kontrol sa proseso ng pag -init.Ang gawaing ito ay karaniwang ginagawa sa isang dalubhasang istasyon ng rework na nilagyan ng mga tool na partikular na idinisenyo para sa trabaho.Ang naisalokal na pag -init ng infrared ay ginagamit upang i -target ang BGA nang hindi nag -init ng mga kalapit na bahagi.Kapag natutunaw ang panghinang sa ilalim ng sangkap, maingat na itinaas ng isang tool na vacuum ang BGA mula sa board.Sa buong prosesong ito, ang init ay dapat na kontrolado nang tumpak upang maiwasan ang mga masasamang sangkap, na itinampok ang pangangailangan para sa mga advanced na kagamitan sa rework.
Ang matagumpay na BGA Rework ay nakasalalay sa pagpapanatili ng tumpak na mga setting ng temperatura at pagkontrol sa kapaligiran sa paligid ng sangkap.Pinipigilan nito ang nakapalibot na circuitry na maapektuhan sa pag -alis at pagpapalit ng isang may sira na BGA.Ang gawain ay hinihiling ng isang malalim na pag -unawa sa kung paano gumana ang mga BGA at bihasang paghawak upang matiyak na maayos ang proseso.Dahil sa mga kumplikadong ito, ang BGA Rework ay isang maselan na operasyon na nangangailangan ng parehong tamang kagamitan at nakaranas ng mga technician upang mapanatili ang integridad ng buong pagpupulong.

Larawan 4: Mga pattern ng lupain ng BGA PCB
Mga diskarte sa disenyo para sa mga pattern ng lupain ng BGA PCB
Ang pagdidisenyo ng mga pattern ng lupa ng PCB para sa mga BGA ay nangangailangan ng tumpak na pansin sa detalye upang matiyak ang isang maayos at ligtas na koneksyon sa panahon ng pagpupulong.Ang mga pattern ng lupa ay dapat na perpektong nakahanay sa grid ng BGA, na tinitiyak na ang bawat panghinang na linya ng bola ay tumpak na may kaukulang pad.Ang mga pangunahing disenyo ng disenyo tulad ng Solder Mask Relief, at sa ilang mga kaso, ang pag -iiwan ng mga pad na walang takip ng maskara, ay ginagamit upang payagan ang mas maraming panghinang na dumaloy at lumikha ng isang mas malakas na bono.Ang mahigpit na pagsunod sa mga pamantayan ng IPC ay kapaki -pakinabang upang makamit ang antas ng kawastuhan na nais para sa matagumpay na paghihinang BGA.
Ang bawat aspeto ng pattern ng lupa ay dapat na maingat na binalak upang matugunan ang mga tiyak na kinakailangan ng sangkap ng BGA.Kasama dito ang pag -aayos ng laki ng mga pad at maingat na pamamahala ng mga positional tolerance upang matiyak na ang bawat koneksyon ay walang kamali -mali.Ang maalalahanin na pagpaplano sa yugto ng disenyo ay nagsisiguro na ang proseso ng paghihinang ay kapwa mahusay at maaasahan, na tumutulong sa BGA na ilakip nang ligtas at gumana nang maayos sa loob ng pagpupulong ng PCB.
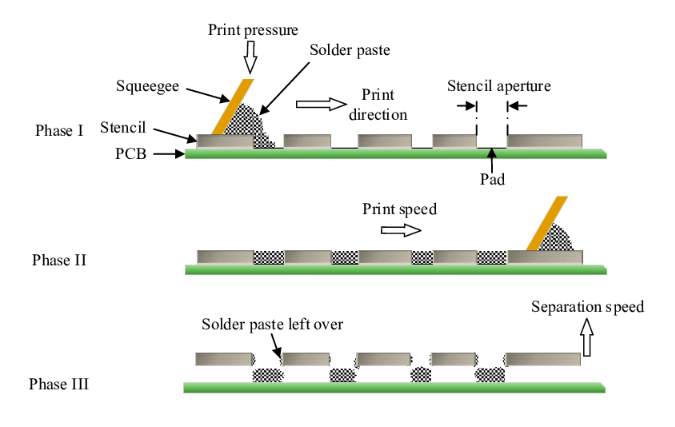
Larawan 5: Ang pag -print ng BGA Solder ay i -print
Pagkamit ng katumpakan sa pag -print ng BGA Solder I -paste
Ang paglalapat ng panghinang na i -paste para sa pagpupulong ng BGA ay nangangailangan ng tumpak na mga diskarte sa stenciling upang matiyak na ang maliit, eksaktong halaga ng paste ay idineposito sa ilalim ng bawat bola ng BGA.Ang prosesong ito ay gumagamit ng mga stencil na pinutol ng laser na perpektong nakahanay sa mga pattern ng lupa ng PCB.Upang higit pang mapabuti ang kawastuhan at mabawasan ang mga depekto tulad ng pagbebenta ng panghinang, ang mga stencil na ito ay madalas na ginagamot sa mga nanocoatings.Ang mga miniature na ulo ng pag -print pagkatapos ay maingat na kontrolin ang dami ng i -paste na inilalapat sa bawat pad, habang ang mga optical system ng pag -verify ay suriin na ang paste ay inilalagay nang may mataas na katumpakan.
Ang uri ng pag -paste ng panghinang na ginamit - Typically Type 3 o Type 4 - nakasalalay sa lagkit na nais para sa tiyak na pagpupulong.Ang pagpili ng i -paste ay direktang nakakaapekto kung gaano kahusay ang form ng mga pinagsamang panghinang sa panahon ng proseso ng pagmuni -muni.Dahil ang hakbang na ito ay naglalagay ng batayan para sa lakas at pagiging maaasahan ng pangwakas na koneksyon, ang proseso ng pag-print ng panghinang ay isang mapanganib na bahagi ng pagpupulong ng BGA, na nangangailangan ng maingat na pansin sa detalye upang matiyak ang mga de-kalidad na resulta.
Mga pagiging kumplikado ng paghihinang ng BGA
Ang paghihinang ng mga BGA ay nagtatanghal ng mga natatanging paghihirap dahil ang mga nagbebenta ng mga kasukasuan ay nakatago sa ilalim ng sangkap, na ginagawang imposible ang direktang visual inspeksyon.Upang matugunan ito, ang mga dalubhasang tool tulad ng mga X-ray machine ay ginagamit upang suriin ang mga koneksyon, habang ang mga istasyon ng rework ng infrared ay nagbibigay-daan para sa tumpak na realignment ng sangkap kung kinakailangan.Ang pamamahala ng proseso ng paghihinang ay nangangailangan din ng maingat na kontrol ng init upang maiwasan ang pag -stress sa mga kasukasuan ng panghinang, na maaaring humantong sa mga bitak.Katulad nito, ang lahat ng mga bola ng panghinang ay dapat mapanatili ang parehong taas (coplanarity) upang matiyak ang pare-pareho ang pagganap at pangmatagalang pagiging maaasahan.
Ang mga kadahilanan sa kapaligiran tulad ng pag -iipon at pagkasensitibo sa kahalumigmigan ay higit na kumplikado ang proseso.Ang mga isyung ito ay kailangang mahigpit na kontrolado upang maiwasan ang pagkasira ng mga kasukasuan ng panghinang sa paglipas ng panahon.Ang matagumpay na pag -navigate sa mga hamong ito ay nangangailangan ng isang masusing pag -unawa sa mga diskarte sa paghihinang ng BGA at ang paggamit ng mga advanced na kagamitan.
Iba't ibang uri ng mga bola grid arrays
Ang teknolohiya ng Ball Grid Array (BGA) ay isang paraan ng pag -mount ng integrated circuit (ICS) papunta sa mga nakalimbag na circuit board (PCB) na nagpapabuti sa koneksyon ng elektrikal at pagwawaldas ng init.Gumagamit ito ng isang hanay ng mga bola ng panghinang sa ilalim ng sangkap upang lumikha ng mga ligtas na koneksyon.

Larawan 6: Mga Arrays ng Plastic Ball Grid (PBGA)
Ang mga plastik na BGA ay malawakang ginagamit dahil ang mga ito ay abot -kayang at naghahatid ng maaasahang pagganap para sa karamihan sa mga karaniwang aplikasyon.Ang mga ito ay binubuo ng isang plastik na substrate na may mga bola ng panghinang na nakakabit sa ilalim.Madalas itong matatagpuan sa mga elektronikong consumer, mga sistema ng automotiko, at iba pang mga aparato na hindi nagpapatakbo sa ilalim ng matinding kondisyon.Ang kanilang simpleng disenyo ay nag -aalok ng mahusay na koneksyon sa koryente at katamtaman na pamamahala ng init, na sapat para sa pang -araw -araw na paggamit.
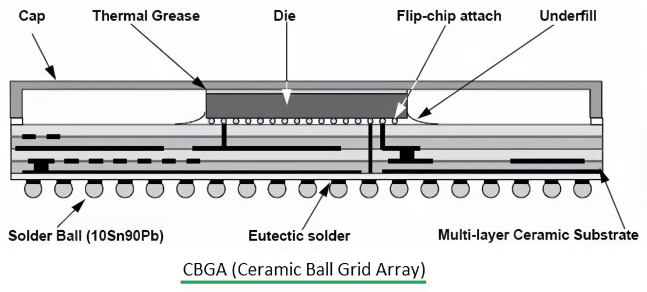
Larawan 7: Ceramic Ball Grid Arrays (CBGA)
Ang mga ceramic BGA ay gumagamit ng isang ceramic substrate, na ginagawang mas lumalaban sa init at elektrikal na panghihimasok kaysa sa mga plastik na BGA.Ang tibay na ito ay ginagawang perpekto para sa hinihingi na mga kapaligiran tulad ng telecommunication, aerospace, at mga high-end server.Ang ceramic ay nagbibigay ng mahusay na pagkakabukod at maaaring hawakan ang parehong mataas na temperatura at mekanikal na stress, tinitiyak ang pangmatagalang pagiging maaasahan ng aparato.
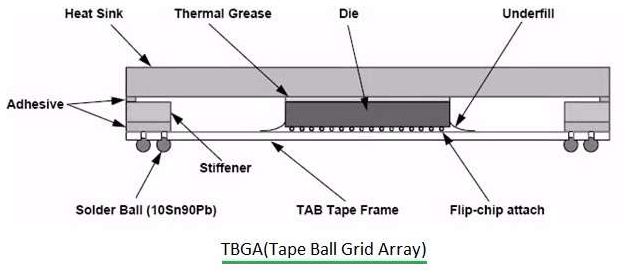
Larawan 8: Tape BGAS (TBGA)
Ang mga tape BGA ay dinisenyo na may isang nababaluktot na substrate na maaaring umayon sa ibabaw ng PCB, pagpapabuti ng parehong koneksyon sa mekanikal at pagwawaldas ng init.Ang mga BGA na ito ay mainam para sa mga portable electronics at high-density na aparato kung saan limitado ang puwang.Ang nababaluktot na likas na katangian ng substrate ay nagbibigay -daan para sa mas mahusay na pamamahala ng thermal sa mga compact na puwang, na ginagawa silang isang ginustong pagpipilian para sa mga smartphone at iba pang mga portable na aparato.
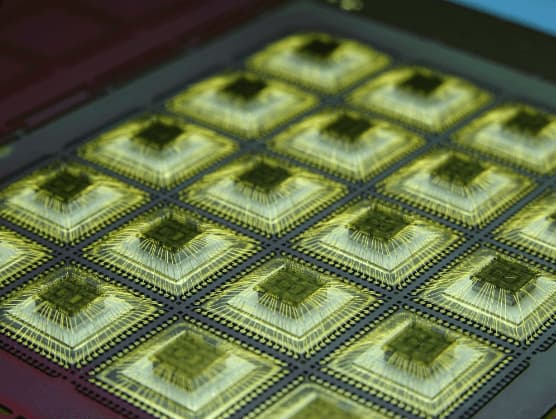
Larawan 9: Nababad na die bgas
Ang mga naka -stack na Die BGA ay ginagamit sa mga aparato na kailangang mag -pack ng maraming lakas sa pagproseso sa isang maliit na puwang.Ang ganitong uri ay nakasalansan ng maraming integrated circuit nang patayo sa loob ng isang solong pakete, na nagpapahintulot sa higit pang pag -andar nang hindi pinatataas ang laki ng aparato.Ang mga naka -stack na Die BGA ay karaniwang matatagpuan sa mga smartphone, tablet, at iba pang mga compact na electronics na nangangailangan ng mataas na pagganap sa isang maliit na kadahilanan ng form.
Konklusyon
Ang paggalugad ng teknolohiya ng Ball Grid Array (BGA) ay binibigyang diin ang pangunahing papel nito sa modernong landscape ng pagmamanupaktura ng electronics.Tulad ng detalyado sa artikulong ito, ang BGA packaging ay hindi lamang tinutugunan ang mga pisikal na limitasyon ng mga mas lumang pamamaraan ng packaging ngunit makabuluhang nagpapabuti din sa pagganap sa pamamagitan ng pinahusay na pamamahala ng init at kahusayan sa kuryente.Ang mga teknikal na proseso na kasangkot sa BGA Soldering, Inspection, at Rework ay sumasalamin sa isang pangako sa katumpakan at pagiging maaasahan, tinitiyak na ang mga elektronikong aparato ay nakakatugon sa mahigpit na mga kinakailangan ng mga pamantayang teknolohikal ngayon.
Bilang karagdagan, ang iba't ibang mga uri ng mga BGA, mula sa mga plastik na BGA hanggang sa mataas na thermal conductivity metal top BGA, ay umaangkop sa isang malawak na spectrum ng mga aplikasyon, na nagpapatunay sa kakayahang magamit at kakayahang umangkop ng teknolohiya ng BGA.Sa huli, habang ang mga elektronikong aparato ay patuloy na nagbabago sa pagiging kumplikado at pag -andar, ang teknolohiya ng BGA ay mananatiling kinakailangan, na patuloy na humimok ng mga pagbabago at mapanatili ang mataas na pamantayan ng kalidad sa semiconductor packaging.
Madalas na Itinanong [FAQ]
1. Paano Magbenta ng isang BGA Package?
Paghahanda: Magsimula sa pamamagitan ng paglilinis ng pakete ng BGA at ang PCB (nakalimbag na circuit board) upang alisin ang anumang mga kontaminado o nalalabi.
Alignment: Maingat na ihanay ang pakete ng BGA sa PCB, tinitiyak na ang lahat ng mga pad sa chip ay nakahanay sa kaukulang mga pad sa board.
Paghihinang: Gumamit ng isang proseso ng paghihinang reflow.Ilagay ang PCB gamit ang BGA sa isang oven ng reflow.Ang panghinang na inilalapat sa mga pad ay matunaw at bubuo ng mga koneksyon sa panahon ng pag -init ng pag -init.
Paglamig: Payagan ang PCB na palamig nang dahan -dahan pagkatapos ng proseso ng pagmuni -muni upang maiwasan ang anumang thermal stress.
2. Ano ang BGA sa paghihinang?
Ang BGA ay nakatayo para sa array ng bola ng grid.Ito ay isang uri ng packaging ng ibabaw-mount na ginagamit para sa mga integrated circuit.Ang mga pakete ng BGA ay gumagamit ng maliliit na bola ng panghinang na naayos sa ilalim ng pakete upang maitaguyod ang mga koneksyon sa koryente sa PCB sa halip na tradisyonal na mga lead.
3. Paano gumawa ng paghihinang bola?
Paglalagay ng bola: Mag -apply ng panghinang i -paste sa mga PCB pad kung saan ilalagay ang BGA.Posisyon ang BGA upang ang bawat bola ng panghinang ay nakahanay sa kaukulang pad sa PCB.
Pag -aalsa ng Pag -aalsa: Init ang pagpupulong sa isang reflow oven.Ang panghinang na i -paste ay matunaw, bonding ang mga bola ng panghinang sa mga pad at lumilikha ng isang solidong koneksyon sa elektrikal at mekanikal.
Inspeksyon: Pagkatapos ng paghihinang, suriin ang mga koneksyon para sa anumang mga tulay o mahinang mga kasukasuan, karaniwang gumagamit ng inspeksyon ng x-ray upang makita sa ilalim ng BGA.
4. Paano suriin ang paghihinang ng BGA?
Visual Inspection: Sa una, suriin para sa anumang nakikitang misalignment o mga depekto sa paligid ng pakete ng BGA.
X-ray inspeksyon: Dahil ang paghihinang ng BGA ay hindi maaaring ganap na napatunayan nang biswal dahil sa nakatagong kalikasan ng mga koneksyon, gumamit ng inspeksyon ng x-ray upang suriin ang mga kasukasuan ng panghinang sa ilalim ng BGA.
Pag -andar ng Pagsubok: Sa wakas, magsagawa ng elektrikal na pagsubok upang matiyak na ang lahat ng mga koneksyon ay gumagana nang tama.
5. Anong temperatura ang dapat maging BGA Solder?
Karaniwang temperatura: Ang tumpak na temperatura para sa paghihinang BGA ay nakasalalay sa ginamit na panghinang na ginamit.Karaniwan, ang lead-free na panghinang na paste ay nangangailangan ng temperatura sa paligid ng 217 ° C hanggang 245 ° C.Suriin ang mga pagtutukoy ng tagagawa ng panghinang para sa eksaktong temperatura.
Profile ng Reflow: Sundin ang isang tiyak na profile ng thermal na unti -unting pinapainit ang pagpupulong sa kinakailangang temperatura ng pagmuni -muni, hawak ito doon nang sapat upang matiyak ang wastong pagtunaw ng panghinang, at pagkatapos ay pinalamig ito nang paunti -unti upang maiwasan ang thermal stress.
Tungkol sa atin
ALLELCO LIMITED
Magbasa nang higit pa
Mabilis na pagtatanong
Mangyaring magpadala ng isang pagtatanong, tutugon kami kaagad.
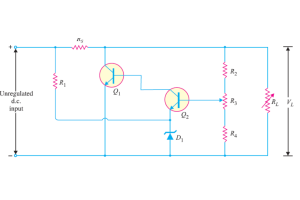
Malalim na pagsusuri ng mga regulator ng boltahe ng shunt sa modernong elektronika
sa 2024/09/9

220 ohm risistor
sa 2024/09/9
Mga sikat na post
-

Ano ang GND sa circuit?
sa 1970/01/1 3033
-

RJ-45 Gabay sa Konektor: RJ-45 Mga Kulay ng Kulay ng Konektor, Mga Scheme ng Wiring, R-J45 Application, RJ-45 Datasheets
sa 1970/01/1 2602
-

Mga Uri ng Connector ng Fiber: SC vs LC at LC vs MTP
sa 1970/01/1 2160
-

Pag -unawa sa mga boltahe ng supply ng kuryente sa electronics VCC, VDD, VEE, VSS, at GND
sa 0400/11/12 2043
-

Paghahambing sa pagitan ng DB9 at RS232
sa 1970/01/1 1786
-

Ano ang baterya ng LR44?
Ang kuryente, na nasa buong lakas na iyon, tahimik na sumisid sa bawat aspeto ng ating pang-araw-araw na buhay, mula sa mga walang kabuluhan na mga gadget hanggang sa nagbabantang kagamitan sa medikal, gumaganap ito ng isang tahimik na papel.Gayunpaman, ang tunay na pagkakahawak ng enerhiya na ito, lalo na kung paano mag -imbak at mahusay na ma -output ito, ay hindi madaling gawain.Ito ay labag sa...sa 1970/01/1 1750
-

Pag -unawa sa mga batayan: paglaban sa inductance, atcapacitance
Sa masalimuot na sayaw ng elektrikal na engineering, isang trio ng mga pangunahing elemento ay tumatagal ng entablado: inductance, paglaban, at kapasidad.Ang bawat isa ay nagdadala ng mga natatanging katangian na nagdidikta sa mga dynamic na ritmo ng mga electronic circuit.Dito, nagsisimula kami sa isang paglalakbay upang matukoy ang mga kumplikado ng mga sangkap na ito, upang alisan ng takip ang ...sa 1970/01/1 1704
-

CR2430 Baterya Comprehensive Guide: Mga pagtutukoy, aplikasyon at paghahambing sa mga baterya ng CR2032
Ano ang baterya ng CR2430?Mga benepisyo ng mga baterya ng CR2430PamantayanCR2430 Mga Application ng BateryaKatumbas ng CR2430CR2430 kumpara sa CR2032Laki ng baterya CR2430Ano ang hahanapin kapag bumili ng CR2430 at katumbasData Sheet PDFMadalas na nagtanong Ang mga baterya ay ang puso ng maliit na elektronikong aparato.Kabilang sa maraming mga uri na magagamit, ang mga cell ng barya ay naglalaro n...sa 1970/01/1 1638
-

Ano ang RF at bakit natin ito ginagamit?
Ang teknolohiya ng Radio Frequency (RF) ay isang pangunahing bahagi ng modernong wireless na komunikasyon, na nagpapagana ng paghahatid ng data sa mga malalayong distansya nang walang pisikal na koneksyon.Ang artikulong ito ay sumasalamin sa mga pangunahing kaalaman ng RF, na nagpapaliwanag kung paano ginagawang posible ang electromagnetic radiation (EMR).Susuriin namin ang mga prinsipyo ng EMR, a...sa 1970/01/1 1616
-

Komprehensibong gabay sa HFE sa mga transistor
Ang mga transistor ay mga mahahalagang sangkap sa mga modernong elektronikong aparato, pagpapagana ng pagpapalakas at kontrol ng signal.Ang artikulong ito ay sumasalamin sa kaalaman na nakapalibot sa HFE, kasama na kung paano pumili ng halaga ng HFE ng transistor, kung paano makahanap ng HFE, at ang pakinabang ng iba't ibang uri ng mga transistor.Sa pamamagitan ng aming paggalugad ng HFE, nakakaku...sa 5600/11/12 1556
















































